
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
A chip gyártási folyamatának teljes magyarázata (1/2): az ostyától a csomagolásig és a tesztelésig
2024-09-18
Minden félvezető termék gyártása több száz folyamatot igényel, és a teljes gyártási folyamat nyolc lépésre oszlik:ostya feldolgozás - oxidáció - fotolitográfia - rézkarc - vékonyréteg-lerakódás - összekapcsolás - tesztelés - csomagolás.
![]()
1. lépés:Ostya feldolgozás
Minden félvezető folyamat egy homokszemmel kezdődik! Mivel a homokban lévő szilícium az ostyák előállításához szükséges alapanyag. Az ostyák szilíciumból (Si) vagy gallium-arzenidből (GaAs) készült egykristály hengerekből vágott kerek szeletek. A nagy tisztaságú szilícium anyagok kinyeréséhez speciális, akár 95%-os szilícium-dioxid tartalmú szilikahomok szükséges, amely egyben az ostyakészítés fő alapanyaga is. Az ostyafeldolgozás a fenti ostyák készítésének folyamata.
Rúdöntés
Először a homokot fel kell melegíteni, hogy elválassza a szén-monoxidot és a szilíciumot, majd a folyamatot addig ismételjük, amíg ultranagy tisztaságú elektronikus minőségű szilíciumot (EG-Si) nem kapunk. A nagy tisztaságú szilícium folyadékká olvad, majd megszilárdul egy kristályos szilárd formává, amelyet "ingotnak" neveznek, ami a félvezetőgyártás első lépése.
A szilícium öntvények (szilícium oszlopok) gyártási pontossága nagyon magas, eléri a nanométer szintet, és a széles körben alkalmazott gyártási módszer a Czochralski módszer.
Rúdvágás
Az előző lépés befejezése után gyémántfűrésszel le kell vágni a tuskó két végét, majd meghatározott vastagságú vékony szeletekre kell vágni. A rúdszelet átmérője határozza meg az ostya méretét. A nagyobb és vékonyabb ostyák használhatóbb egységekre oszthatók, ami segít csökkenteni a gyártási költségeket. A szilícium tuskó levágása után a szeletekre "sima terület" vagy "horpadás" jeleket kell helyezni, hogy megkönnyítsék a feldolgozási irány szabványos beállítását a következő lépésekben.
Ostya felületi polírozás
A fenti vágási eljárással nyert szeleteket "csupasz ostyának", azaz feldolgozatlan "nyers ostyának" nevezik. A csupasz ostya felülete egyenetlen, és az áramköri mintát nem lehet közvetlenül rányomtatni. Ezért először a felületi hibákat csiszolással és vegyi maratással kell eltávolítani, majd polírozni, hogy sima felületet alakítsunk ki, majd tisztítással eltávolítani a maradék szennyeződéseket, hogy tiszta felületű ostyát kapjunk.
2. lépés: Oxidáció
Az oxidációs folyamat szerepe, hogy védőfóliát képezzen az ostya felületén. Megvédi az ostyát a vegyi szennyeződésektől, megakadályozza a szivárgó áram bejutását az áramkörbe, megakadályozza a diffúziót az ionimplantáció során, és megakadályozza, hogy az ostya elcsússzon a maratás során.
Az oxidációs folyamat első lépése a szennyeződések és szennyeződések eltávolítása. Négy lépést igényel a szerves anyagok, fémszennyeződések eltávolítása és a maradék víz elpárologtatása. Tisztítás után az ostya 800-1200 Celsius fokos magas hőmérsékletű környezetbe helyezhető, és az ostya felületén oxigén vagy gőz áramlásával szilícium-dioxid (azaz "oxid") réteg alakul ki. Az oxigén átdiffundál az oxidrétegen, és reakcióba lép a szilíciummal, és változó vastagságú oxidréteget képez, amelynek vastagsága az oxidáció befejezése után mérhető.

Száraz oxidáció és nedves oxidáció Az oxidációs reakcióban részt vevő különböző oxidálószerektől függően a termikus oxidációs folyamat száraz oxidációra és nedves oxidációra osztható. Az előbbi tiszta oxigén felhasználásával szilícium-dioxid réteget állít elő, amely lassú, de az oxidréteg vékony és sűrű. Ez utóbbihoz oxigénre és jól oldódó vízgőzre is szükség van, amelyet gyors növekedési ütem, de viszonylag vastag, kis sűrűségű védőréteg jellemez.
Az oxidálószeren kívül más változók is befolyásolják a szilícium-dioxid réteg vastagságát. Először is, az ostya szerkezete, felületi hibái és belső adalékkoncentrációja befolyásolja az oxidréteg képződésének sebességét. Ezenkívül minél nagyobb nyomást és hőmérsékletet generál az oxidáló berendezés, annál gyorsabban képződik az oxidréteg. Az oxidációs folyamat során az ostya egységben elfoglalt helyzetének megfelelő próbalapot is szükséges használni az ostya védelme és az oxidációs fok különbségének csökkentése érdekében.
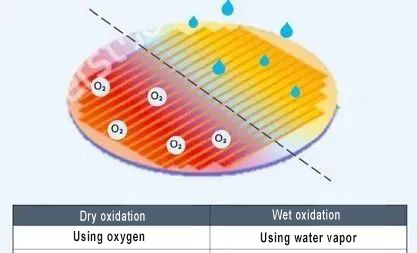
3. lépés: Fotolitográfia
A fotolitográfia célja az áramköri minta „nyomtatása” az ostyára fényen keresztül. Érthetjük úgy, hogy a félvezetőgyártáshoz szükséges síktérképet rajzoljuk a lapka felületére. Minél nagyobb az áramköri mintázat finomsága, annál jobban integrálódik a kész chip, amit fejlett fotolitográfiai technológiával kell elérni. Pontosabban, a fotolitográfia három lépésre osztható: fotoreziszt bevonat, expozíció és előhívás.
Bevonat
Az áramkör ostyára való rajzolásának első lépése az, hogy a fotorezisztet bevonjuk az oxidrétegre. A Photoresist a kémiai tulajdonságainak megváltoztatásával az ostyát "fotópapírrá" teszi. Minél vékonyabb a fotoreziszt réteg az ostya felületén, annál egyenletesebb a bevonat, és annál finomabb a nyomtatható minta. Ezt a lépést a "spin coating" módszerrel lehet elvégezni. A fény (ultraibolya) reaktivitás különbsége szerint a fotorezisztek két típusra oszthatók: pozitív és negatív. Az előbbi a fény hatására lebomlik és eltűnik, meghagyva a megvilágítatlan terület mintázatát, míg az utóbbi a fény hatására polimerizálódik, és a kitett rész mintázatát jeleníti meg.
Kitettség
Miután a fotoreziszt filmet az ostyára borították, az áramköri nyomtatás befejezhető a fényexpozíció szabályozásával. Ezt a folyamatot "expozíciónak" nevezik. A fényt szelektíven tudjuk átengedni az exponáló berendezésen. Amikor a fény áthalad az áramköri mintát tartalmazó maszkon, az áramkör rányomtatható az alábbi fotoreziszt filmmel bevont ostyára.
Az expozíciós folyamat során minél finomabb a nyomtatott minta, annál több komponenst tud befogadni a végső chip, ami segít a gyártás hatékonyságának javításában és az egyes alkatrészek költségének csökkentésében. Ezen a területen az új technológia, amely jelenleg nagy figyelmet kelt, az EUV litográfia. A Lam Research Group az ASML és az imec stratégiai partnereivel közösen kifejlesztett egy új szárazfilmes fotoreziszt technológiát. Ez a technológia nagymértékben javíthatja az EUV litográfiai expozíciós folyamat termelékenységét és hozamát a felbontás javításával (ez kulcsfontosságú tényező az áramköri szélesség finomhangolásában).
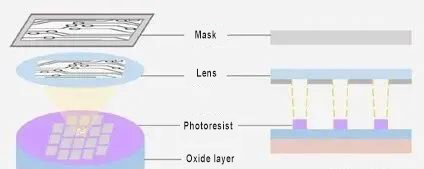
Fejlesztés
Az expozíció utáni lépés az előhívó felfújása az ostyára, a cél a minta fedetlen részén lévő fotoreziszt eltávolítása, így a nyomtatott áramköri minta láthatóvá válik. A fejlesztés befejezése után különböző mérőberendezésekkel és optikai mikroszkóppal ellenőrizni kell, hogy a kapcsolási rajz minősége megbizonyosodjon.
4. lépés: Rézkarc
Miután az áramköri diagram fotolitográfiája elkészült az ostyán, maratási eljárást alkalmaznak a felesleges oxidfilm eltávolítására, és csak a félvezető kapcsolási rajzát hagyják meg. Ehhez folyadékot, gázt vagy plazmát használnak a kiválasztott felesleges részek eltávolítására. A felhasznált anyagoktól függően két fő módszer létezik a maratásra: nedves maratás speciális kémiai oldattal, amely kémiai reakcióba lép az oxidfilm eltávolítása érdekében, és száraz marás gázzal vagy plazmával.
Nedves maratás
Az oxidfilmek eltávolítására szolgáló kémiai oldatokkal végzett nedves maratás előnye az alacsony költség, a gyors maratási sebesség és a nagy termelékenység. A nedves maratás azonban izotróp, azaz sebessége minden irányban azonos. Emiatt a maszk (vagy az érzékeny fólia) nem illeszkedik teljesen a maratott oxidfilmhez, így nehéz nagyon finom kapcsolási rajzokat feldolgozni.

Száraz rézkarc
A száraz maratás három különböző típusra osztható. Az első a kémiai maratás, amely maratógázokat (főleg hidrogén-fluoridot) használ. A nedves maratáshoz hasonlóan ez a módszer izotróp, ami azt jelenti, hogy nem alkalmas finom maratásra.
A második módszer a fizikai porlasztás, amely a plazmában lévő ionokat használja a felesleges oxidréteg beütésére és eltávolítására. Anizotrop maratási módszerként a porlasztásos maratás vízszintes és függőleges irányban eltérő marási sebességgel rendelkezik, így finomsága is jobb, mint a kémiai maratásé. Ennek a módszernek azonban az a hátránya, hogy a maratási sebesség lassú, mert teljes mértékben az ionütközés okozta fizikai reakcióra támaszkodik.
Az utolsó harmadik módszer a reaktív ionmaratás (RIE). A RIE az első két módszert egyesíti, vagyis míg a plazmát ionizációs fizikai maratásra használjuk, addig a kémiai maratást a plazmaaktiválás után keletkező szabad gyökök segítségével végezzük. Amellett, hogy a maratási sebesség meghaladja az első két módszert, a RIE felhasználhatja az ionok anizotróp tulajdonságait a nagy pontosságú mintamaratáshoz.
Napjainkban a száraz maratást széles körben alkalmazzák a finom félvezető áramkörök hozamának javítására. A teljes szelet maratási egyenletességének megőrzése és a maratási sebesség növelése kritikus fontosságú, és a mai legfejlettebb szárazmaratási berendezés támogatja a legfejlettebb logikai és nagyobb teljesítményű memóriachipek gyártását.

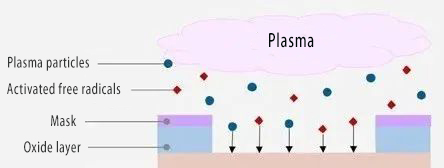
A VeTek Semiconductor egy professzionális kínai gyártóTantál-karbid bevonat, Szilícium-karbid bevonat, Speciális grafit, Szilícium-karbid kerámiaésEgyéb félvezető kerámiák. A VeTek Semiconductor elkötelezett amellett, hogy fejlett megoldásokat kínáljon különféle SiC Wafer termékekhez a félvezetőipar számára.
Ha érdekli a fenti termékek, kérjük, forduljon hozzánk közvetlenül.
Mob: +86-180 6922 0752
WhatsAPP: +86 180 6922 0752
E-mail: anny@veteksemi.com




