
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Kína Szilícium-karbid epitaxia Gyártó, szállító, gyár
A kiváló minőségű szilícium-karbid epitaxia elkészítése a fejlett technológiától, valamint a berendezésektől és tartozékoktól függ. Jelenleg a legszélesebb körben használt szilícium-karbid epitaxiás növekedési módszer a kémiai gőzlerakódás (CVD). Előnyei az epitaxiális filmvastagság és az adalékkoncentráció pontos szabályozása, a kevesebb hiba, a mérsékelt növekedési sebesség, az automatikus folyamatszabályozás stb., és megbízható technológia, amelyet sikeresen alkalmaztak a kereskedelemben.
A szilícium-karbid CVD epitaxia általában melegfalú vagy melegfalú CVD-berendezést alkalmaz, amely biztosítja az epitaxiaréteg 4H kristályos SiC folyamatos működését magas növekedési hőmérsékleti körülmények között (1500 ~ 1700 ℃), melegfalú vagy melegfalú CVD-ben, több éves fejlesztés után. kapcsolat a bemeneti levegő áramlási iránya és a szubsztrát felülete között, A reakciókamra felosztható vízszintes szerkezetű reaktorra és függőleges szerkezetű reaktorra.
A SIC epitaxiális kemence minőségének három fő mutatója van, az első az epitaxiális növekedési teljesítmény, beleértve a vastagság egyenletességét, az adalékolás egyenletességét, a hibaarányt és a növekedési sebességet; A második maga a berendezés hőmérsékleti teljesítménye, beleértve a fűtési/hűtési sebességet, a maximális hőmérsékletet, a hőmérséklet egyenletességét; Végül magának a berendezésnek a költséghatékonysága, beleértve egyetlen egység árát és kapacitását.
Háromféle szilícium-karbid epitaxiális növesztő kemence és magtartozékok különbségei
A melegfalú vízszintes CVD (az LPE cég tipikus PE1O6 modellje), a melegfalú planetáris CVD (tipikus Aixtron G5WWC/G10 modell) és a kvázi melegfalú CVD (amelyet a Nuflare cég EPIREVOS6 képvisel) az epitaxiális berendezések főbb műszaki megoldásai, amelyeket megvalósítottak. kereskedelmi alkalmazásokban ebben a szakaszban. A három műszaki eszköznek is megvan a maga sajátossága, és igény szerint választható. Szerkezetük a következőképpen látható:
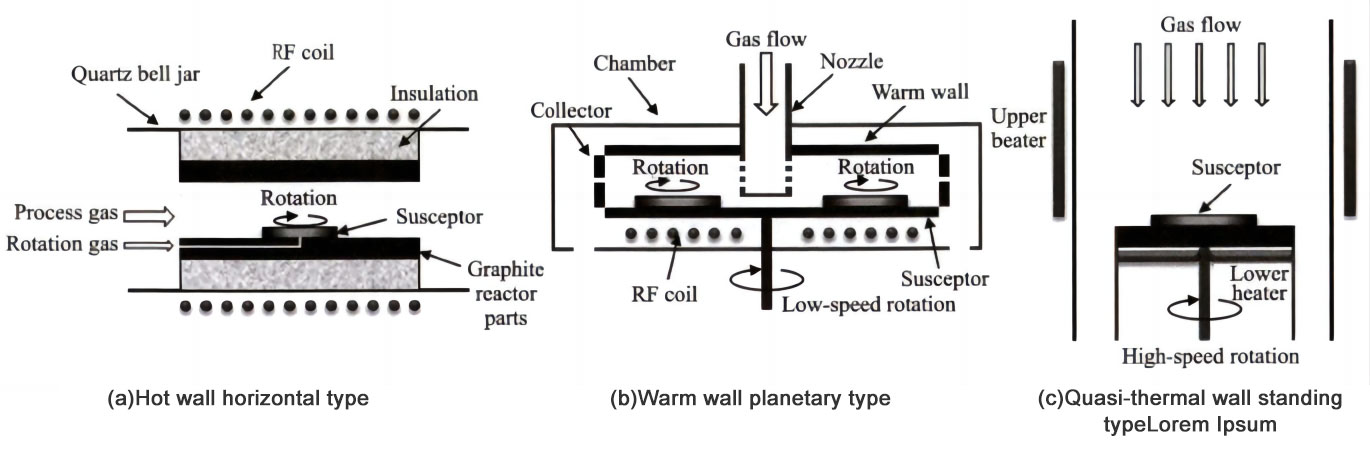
A megfelelő alapvető összetevők a következők:

(a) Forró fal vízszintes típusú magrész- Halfmoon Parts áll
Lefelé irányuló szigetelés
Fő szigetelő felsőrész
Felső félhold
Felfelé irányuló szigetelés
Átmeneti darab 2
Átmeneti darab 1
Külső levegő fúvóka
Kúpos légzőcső
Külső argon gázfúvóka
Argon gázfúvóka
Ostya tartólemez
Központosító csap
Központi őr
Lefelé bal oldali védőburkolat
Alsó jobb oldali védőburkolat
Előtt bal oldali védőburkolat
Jobb oldali védőburkolat
Oldalfal
Grafit gyűrű
Védő filc
Támogató filc
Kontaktblokk
Gázkimeneti henger

(b) Melegfalú bolygótípus
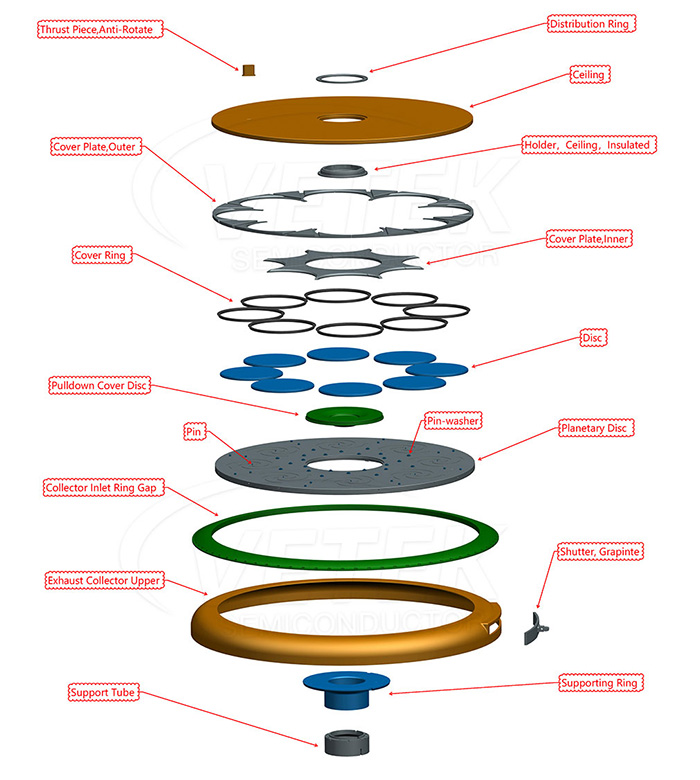

SiC bevonatú Planetary Disk & TaC bevonatú Planetary Disk
c) Kvázi-termikus fali állvány
Nuflare (Japán): Ez a cég kétkamrás függőleges kemencéket kínál, amelyek hozzájárulnak a termelés növeléséhez. A berendezés nagy sebességű, akár 1000 fordulat/perc fordulatszámmal rendelkezik, ami rendkívül előnyös az epitaxiális egyenletesség szempontjából. Ezen túlmenően légáramlási iránya eltér a többi berendezéstől, függőlegesen lefelé irányul, így minimálisra csökkenti a részecskék képződését és csökkenti annak valószínűségét, hogy részecskecseppek hulljanak az ostyákra. Ehhez a berendezéshez SiC bevonatú grafit alkatrészeket biztosítunk.

A SiC epitaxiális berendezések alkatrészeinek szállítójaként a VeTek Semiconductor elkötelezett amellett, hogy ügyfeleit kiváló minőségű bevonatelemekkel lássa el a SiC epitaxia sikeres megvalósításának támogatása érdekében.
- View as
LPE Halfmoon SiC EPI reaktor
A VeTek Semiconductor egy professzionális LPE Halfmoon SiC EPI Reactor termékgyártó, innovátor és vezető Kínában. Az LPE Halfmoon SiC EPI Reactor egy olyan eszköz, amelyet kifejezetten kiváló minőségű szilícium-karbid (SiC) epitaxiális rétegek előállítására terveztek, főként a félvezetőiparban. A VeTek Semiconductor elkötelezett amellett, hogy vezető technológiát és termékmegoldásokat biztosítson a félvezetőipar számára, és üdvözli további megkereséseit.
Olvass továbbKérdés küldéseCVD SiC bevonatú mennyezet
Professzionális CVD SiC bevonatú mennyezetgyártóként és beszállítóként Kínában, a VeTek Semiconductor CVD SiC bevonatú mennyezete kiváló tulajdonságokkal rendelkezik, mint például a magas hőmérséklet-állóság, a korrózióállóság, a nagy keménység és az alacsony hőtágulási együttható, így ideális anyagválasztás a félvezetőgyártásban. Várjuk a további együttműködést Önnel.
Olvass továbbKérdés küldéseCVD SiC grafit henger
A Vetek Semiconductor CVD SiC grafithengere kulcsfontosságú a félvezető berendezésekben, védőpajzsként szolgál a reaktorokban, hogy megóvja a belső alkatrészeket magas hőmérsékleten és nyomáson. Hatékonyan véd a vegyszerek és az extrém hőhatások ellen, megőrzi a berendezés épségét. Kivételes kopás- és korrózióállóságával hosszú élettartamot és stabilitást biztosít kihívásokkal teli környezetben. Ezeknek a burkolatoknak a használata javítja a félvezető eszközök teljesítményét, meghosszabbítja az élettartamot, valamint mérsékli a karbantartási igényeket és a károsodási kockázatokat.
Olvass továbbKérdés küldéseCVD SiC bevonatfúvóka
A Vetek Semiconductor CVD SiC bevonatfúvókái az LPE SiC epitaxiás eljárásban használt kulcsfontosságú komponensek a félvezetőgyártás során a szilícium-karbid anyagok felhordására. Ezek a fúvókák jellemzően magas hőmérsékletű és kémiailag stabil szilícium-karbid anyagból készülnek, hogy biztosítsák a stabilitást kemény feldolgozási környezetben. Az egyenletes felhordásra tervezték, kulcsszerepet játszanak a félvezető alkalmazásokban termesztett epitaxiális rétegek minőségének és egyenletességének ellenőrzésében. Várjuk, hogy hosszú távú együttműködést alakítsunk ki Önnel.
Olvass továbbKérdés küldéseCVD SiC bevonatvédő
A Vetek Semiconductor CVD SiC bevonatvédőt biztosít. A használt LPE SiC epitaxia. Az "LPE" kifejezés általában az alacsony nyomású kémiai gőzleválasztásban (LPCVD) alacsony nyomású epitaxiára (LPE) utal. A félvezetőgyártásban az LPE fontos folyamattechnológia az egykristály vékonyrétegek termesztésére, amelyet gyakran szilícium epitaxiális rétegek vagy más félvezető epitaxiális rétegek növesztésére használnak. További kérdéseivel forduljon hozzánk bizalommal.
Olvass továbbKérdés küldéseSiC bevonatú talapzat
A Vetek Semiconductor professzionális a CVD SiC bevonat, TaC bevonat grafit és szilícium-karbid gyártásában. OEM- és ODM-termékeket kínálunk, mint például SiC bevonatú talapzat, ostyatartó, ostyatokmány, ostyatartó tálca, bolygólemez és így tovább. Az 1000-es tisztaságú tisztatérrel és tisztítóberendezéssel 5 ppm alatti szennyeződésű termékeket tudunk biztosítani. Várjuk a meghallgatást. hamarosan tőled.
Olvass továbbKérdés küldése












